封装技术发展态势

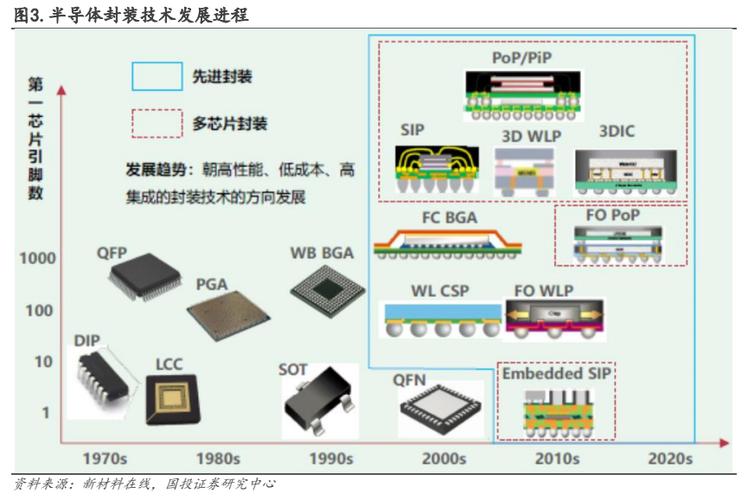
英特尔近期在处理器封装领域实现了重大突破,成功研发了多种新型封装技术,如EMIB 2.5D和Foveros 3D。公司持续推动技术创新,打破了传统封装模式的限制。这些技术通常被结合运用,从而有助于生产出性能更卓越、结构更为复杂的芯片。


技术种类繁多,增长势头强劲。新技术的涌现,满足了各领域对芯片性能增强的需求,并在电脑、服务器等行业中扮演着愈发关键的角色。
玻璃核心关键特性


英特尔强调,玻璃核心技术的发展至关重要。首先,微凸点技术增强了芯片连接的稳定性与传输效率;其次,扩大基板尺寸可容纳更多芯片与线路;再者,提升的高速传输能力加速了数据交换,进而提升了芯片的处理速度。
这些特性相互协作,显著提升了玻璃基芯片的性能。其卓越的扩展性确保了芯片能够适应多样化的应用场景,无论是便携式设备还是大型服务器。

FCBGA 2D与改进款


FCBGA 2D封装属于传统有机封装范畴,目前正广泛用于生产。这种封装类型特别适用于成本敏感的基础级产品。这类产品一般不要求高速的I/O接口或芯片间的高带宽连接,如一些入门级电脑处理器。
FCBGA 2D+技术引入了基板层叠功能。该技术特别适合于芯片结构相对简单、主板连接区域尺寸较大的产品,例如网络和交换设备。采用FCBGA 2D+技术,不仅确保了产品性能,而且有效降低了成本。
EMIB 2.5D特点及应用

EMIB 2.5D技术适用于单层芯片设计,并且支持HBM堆叠应用的兼容性。芯片间的连接是通过基板上的微型硅桥实现的,这种连接方式尤其适合用于实现高密度芯片间的互联。
该技术在人工智能及高性能计算领域表现突出。它促使众多芯片实现协作,大幅提升了数据处理的速度与效率。这一进步加速了AI算法的运行,同时保障了高性能计算任务的顺利完成。
EMIB 3.5D创新优势
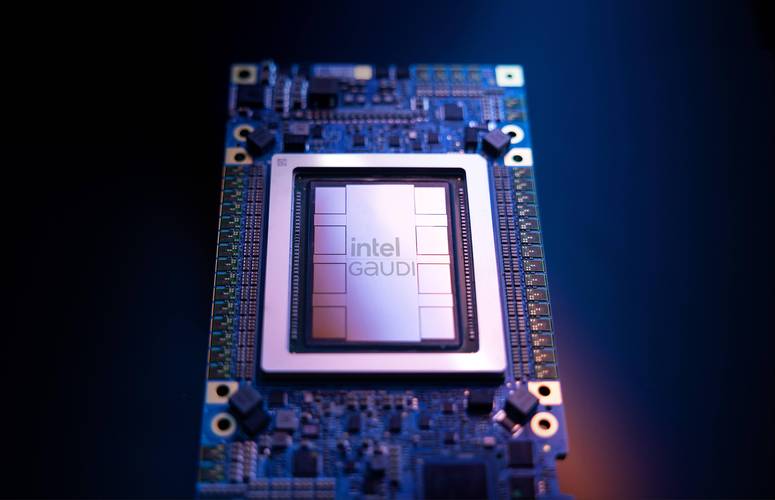
EMIB 3.5D型产品采用了3D堆叠技术,将芯片安装在带电或无电的基板上。此技术增强了芯片封装的适应性。针对需满足较大互联距离和较低延迟的IP模块,垂直堆叠技术得以应用。


这些定义明确、设计完成且已生产的GPU及HBM芯片,通过EMIB 2.5D技术实现集成,无需对现有设计进行修改,即可无缝融入EMIB 3.5D封装系统中。该技术显著降低了芯片生产所需的时间和成本。
技术协同与测试服务

封装技术广泛采用,尤其在人工智能和高性能计算产品领域,此做法尤为普遍。例如,Foveros Direct 3D技术与HBM可能结合,用于实现EMIB 3.5D封装,以此充分发挥各自技术的潜力。
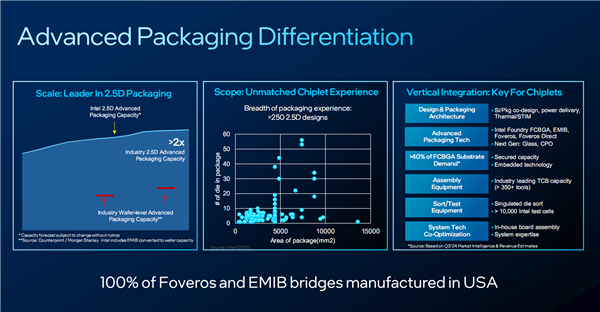

在基板制造环节,操作通常在大型方形面板上展开,这一做法提升了面板的使用效率。在裸片堆叠与封装完成之前,会实施“堆叠芯片测试”,其目的是验证芯片的功能与性能是否满足标准。同时,Intel在晶圆制造过程中向客户提供了多样化的服务。关于Intel的封装技术,我们预计它们将在多个领域实现显著突破。